Курсовая работа: Современные методы изучения вещества просвечивающий электронный микроскоп
СОДЕРЖАНИЕ
Введение
1. Историческая справка
2. Просвечивающая электронная микроскопия
2.1 Источники электронов
2.2 Система освещения
2.3 Коррекция астигматизма
2.4 Вспомогательное оборудование для ОПЭМ
3. Применение просвечивающего электронного микроскопа
3.1 Небиологические материалы
3.2 Биологические препараты
3.3 Высоковольтная микроскопия
3.4 Радиационное повреждение
4. Современные виды ПЭМ
Заключение
Список литературы
ВВЕДЕНИЕ
Методы электронной микроскопии завоевали такую популярность, что в настоящее время невозможно представить себе лабораторию, занимающуюся исследованием материалов, их не применяющую. Первые успехи электронной микроскопии следует отнести к 30-м годам, когда с ее помощью была выявлена структура ряда органических материалов и биологических объектов. В исследованиях неорганических материалов, в особенности металлических сплавов, позиции электронной микроскопии укрепились с появлением микроскопов с высоким напряжением (100 кВ и выше) и еще в большей мере благодаря совершенствованию техники получения объектов, позволившей работать непосредственно с материалом, а не со слепками-репликами. Именно так называемой просвечивающей электронной микроскопии обязана своим появлением и постоянным развитием теория дислокаций – механизма пластической деформации материалов. Прочные позиции занимает электронная микроскопия и в ряде других разделов материаловедения.
Усиление интереса к электронной микроскопии объясняется рядом обстоятельств. Это, во-первых, расширение возможностей метода благодаря появлению самых различных приставок: для исследований при низких (до – 150°С) и высоких (до 1200°С) температурах, наблюдения деформации непосредственно в микроскопе, исследования рентгеновских спектров микроучастков (до 1 мкм и менее) объектов, получения изображений в рассеянных электронах и др. Во-вторых, существенное повышение (до 1 Å и менее) разрешающей способности электронных микроскопов, что сделало их конкурентоспособными с автоионными микроскопами в получении прямых изображений кристаллической решетки. Наконец, возможность параллельно с микроскопическими исследованиями детально изучать дифракционные картины вплоть до наблюдения таких тонких деталей, как диффузионное рассеяние электронов.
Все шире шагает и растровая электронная микроскопия, сконцентрировавшая все достижения просвечивающей электронной микроскопии.
1. ИСТОРИЧЕСКАЯ СПРАВКА
История микроскопии – это история непрерывных поисков человека, стремившегося проникнуть в тайны природы. Микроскоп появился в XVII в., и с этих пор наука стала быстро продвигаться вперед. Многие поколения исследователей проводили за микроскопом долгие часы, изучая не видимый глазу мир. Сегодня трудно себе представить биологическую, медицинскую, физическую, металлографическую, химическую лаборатории без оптического микроскопа: исследуя капельки крови и срез ткани, медики составляют заключение о состоянии здоровья человека. Установление структуры металла и органических веществ позволило разработать целый ряд новых высокопрочных металлических и полимерных материалов.
Наше столетие часто называют электронным веком. Проникновение в тайны атома позволило сконструировать электронные приборы – лампы, электронно-лучевые трубки и др. В начале 20-х годов у физиков возникла идея использовать пучок электронов для формирования изображения предметов. Реализация этой идеи породила электронный микроскоп.
Широкие возможности получения самой разнообразной информации, в том числе и с участков объектов, соизмеримых с атомом, послужили стимулом к совершенствованию электронных микроскопов и применению их практически во всех областях науки и техники в качестве приборов для физических исследований и технического контроля.
Современный электронный микроскоп способен различать столь малые детали изображения микрообъекта, которые не в состоянии обнаружить ни один другой прибор. В еще большей степени, чем размеры и форма изображения, ученых интересует структура микрообъекта; и электронные микроскопы могут рассказать не только о структуре, но и о химическом составе, несовершенствах строения участков микрообъекта размером в доли микрометра. Благодаря этому сфера применения электронного микроскопа непрерывно расширяется и сам прибор усложняется.
Первые просвечивающие электронные микроскопы работали с напряжением, ускоряющим электроны, в 30 – 60 кВ; толщина исследуемых объектов едва достигала 1000 Å (1 Å – 10-10 м). В настоящее время созданы электронные микроскопы с ускоряющим напряжением в 3 МВ, что позволило наблюдать объекты толщиной уже в несколько микрометров. Однако успехи электронной микроскопии не ограничились только количественным ростом ускоряющего напряжения. Этапным стало создание серийного растрового электронного микроскопа (РЭМ), который сразу же завоевал популярность у физиков, химиков, металлургов, геологов, медиков, биологов и даже у криминалистов. Наиболее существенные особенности этого прибора – большая глубина резкости изображения, которая на несколько порядков выше, чем у микроскопа оптического, и возможность исследования массивных образцов практически без какой-либо их специальной подготовки. Эволюция идей физики неразрывно связана с развитием методов исследования, позволяющих объяснить явления, происходящие в микромире. В развитии любой науки, изучающей реальные физические тела, два вопроса являются основными: как ведет себя тело в тех или иных условиях? Почему оно ведет себя определенным образом? Наиболее полный на эти вопросы ответ можно получить, если рассматривать структуру тела и его поведение комплексно, т. е. от микросвязей и микроструктуры до макроструктуры в макропроцессор. В XIX в, окончательно была сформулирована теория изображения, и физикам стало очевидно, что для улучшения разрешения микроскопа нужно уменьшать длину волны излучения, формирующего изображение. Сначала это открытие не привело к практическим результатам. Только благодаря работе Луи де Бройля (1924 г.)[1], в которой связывалась длина волны частицы с ее массой и скоростью, из чего следовало, что и для электронов (как и для световых золи) должно иметь место явление дифракции; и Буша (1926 г.), показавшего, что электрические и магнитные поля действуют почти как оптические линзы, стало возможным вести конкретный разговор об электронной оптике.
В 1927 г. американские ученые К. Девиссои и Л. Джермер наблюдали явление дифракции электронов, а английский физик Д. Томсон и со- ветский физик П. С. Тартаковский провели первые исследования этого явления. В начале 30-х годов академик А. А. Лебедев разработал теорию дифракции в приложении к электронографу [2].
На основе этих основополагающих работ стало возможным создать электронно-оптический прибор, и де Бройль предложил заняться этим одному из своих учеников, Л. Сциларду [2] . Тот в разговоре с известным физиком Д. Табором рассказал ему о предложении де Бройля, однако Габор убедил Сциларда в том, что любой предмет, находящийся на пути электронного луча, сгорит дотла и, кроме того, живые объекты в вакуум помешать нельзя.
Сцилард отказался от предложения своего учителя, но к тому времени уже не существовало трудностей в получении электронов. Физики и радиотехники успешно работали с электронными лампами, в которых электроны получали за счет термоэлектронной эмиссии, или, попросту говоря, за счет нагревания нити (катода), а направленное движение электронов к аноду (т. е. прохождение тока через лампу) формировалось приложением напряжения между анодом и катодом. В 1931 г. А. А. Лебедев предложил схему электронографа с магнитной фокусировкой пучка электронов, которая легла в основу большинства приборов, изготовленных в нашей стране и за рубежом.
В 1931 Р.Руденберг подал патентную заявку на просвечивающий электронный микроскоп, а в 1932 М.Кнолль и Э.Руска построили первый такой микроскоп, применив магнитные линзы для фокусировки электронов. Этот прибор был предшественником современного ОПЭМ. (Руска был вознагражден за свои труды тем, что стал лауреатом Нобелевской премии по физике за 1986.) [2]
В 1938 Руска и Б. фон Боррис построили прототип промышленного ОПЭМ для фирмы "Сименс-Хальске" в Германии; этот прибор в конце концов позволил достичь разрешения 100 нм. Несколькими годами позднее А.Пребус и Дж.Хиллер построили первый ОПЭМ высокого разрешения в Торонтском университете (Канада).
Широкие возможности ОПЭМ почти сразу же стали очевидны. Его промышленное производство было начато одновременно фирмой "Сименс-Хальске" в Германии и корпорацией RCA в США. В конце 1940-х годов такие приборы стали выпускать и другие компании.
РЭМ в его нынешней форме был изобретен в 1952 Чарльзом Отли. Правда, предварительные варианты такого устройства были построены Кноллем в Германии в 1930-х годах и Зворыкиным с сотрудниками в корпорации RCA в 1940-х годах, но лишь прибор Отли смог послужить основой для ряда технических усовершенствований, завершившихся внедрением в производство промышленного варианта РЭМ в середине 1960-х годов. Круг потребителей такого довольно простого в обращении прибора с объемным изображением и электронным выходным сигналом расширился с быстротой взрыва. В настоящее время насчитывается добрый десяток промышленных изготовителей РЭМ'ов на трех континентах и десятки тысяч таких приборов, используемых в лабораториях всего мира. В 1960-х годах разрабатывались сверхвысоковольтные микроскопы для исследования более толстых образцов. Лидером этого направления разработок был Г.Дюпуи во Франции, где в 1970 был введен в действие прибор с ускоряющим напряжением, равным 3,5 млн. вольт. РТМ был изобретен Г.Биннигом и Г.Рорером в 1979 в Цюрихе. Этот весьма простой по устройству прибор обеспечивает атомное разрешение поверхностей. За свою работу по созданию РТМ Бинниг и Рорер (одновременно с Руской) получили Нобелевскую премию по физике.
Широкое развитие методов электронной микроскопии в нашей стране связано с именами ряда ученых: Н. Н. Буйнова, Л. М. Утевского, Ю. А. Скакова (просвечивающая микроскопия), Б. К. Вайнштейна (электронография), Г. В. Спивака (растровая микроскопия), И. Б. Боровского, Б. Н. Васичева (рентгеновская спектроскопия) и др. Благодаря им электронная микроскопия вышла, из стен научно-исследовательских институтов и находит все более широкое применение в заводских лабораториях.
2. ПРОСВЕЧИВАЮЩАЯ ЭЛЕКТРОННАЯ МИКРОСКОПИЯ
Электронный микроскоп – прибор, который позволяет получать сильно увеличенное изображение объектов, используя для их освещения электроны. Электронный микроскоп (ЭМ) дает возможность видеть детали, слишком мелкие, чтобы их мог разрешить световой (оптический) микроскоп. Электронный микроскоп – один из важнейших приборов для фундаментальных научных исследований строения вещества, особенно в таких областях науки, как биология и физика твердого тела.
Познакомимся с конструкцией современного просвечивающего электронного микроскопа.
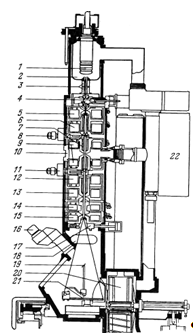
Рисунок 1 – Разрез, показывающий основные узлы просвечивающего электронного микроскопа [2]
1 – электронная пушка; 2 – анод; 3 – катушка для юстировки пушки; 4 – клапан пушки; 5 – 1-я конденсорная линза; 6 – 2-я конденсорная линза; 7 – катушка для наклона пучка; 8 – конденсор 2 диафрагмы; 9 – объективная линза; 10 – блок образца; 11 – дифракционная диафрагма; 12 – дифракционная линза; 13 – промежуточная линза; 14 – 1-я проекционная линза; 15 – 2-я проекционная линза;
16 – бинокуляр (увеличение 12); 17 – вакуумный блок колонны; 18 – камера для 35-миллиметровой катушечной пленки; 19 – экран для фокусировки; 20 – камера для пластинок; 21 – главный экран; 22 – ионный сорбционный насос.
Принцип его построения [2] в общем аналогичен принципу микроскопа оптического, имеются осветительная (электронная пушка), фокусирующая (линзы) и регистрирующая (экран) системы. Тем не менее он сильно отличается в деталях. Например, свет беспрепятственно распространяется в воздухе, тогда как электроны легко рассеиваются при взаимодействии с любым веществом и, следовательно, беспрепятственно могут перемещаться только в вакууме. Иными словами, микроскоп помещают в вакуумную камеру.
Рассмотрим более детально узлы микроскопа. Система из нити накала и ускоряющих электродов носит название электронной пушки (1). В сущности, пушка напоминает триодную лампу. Поток электронов испускается раскаленной вольфрамовой проволочкой (катодом), собирается в пучок и ускоряется в поле двух электродов. Первый – управляющий электрод, или так называемый "цилиндр Венельта", окружает катод, и на него подается напряжение смещения, небольшой отрицательный относительно катода потенциал в несколько сотен вольт. Благодаря наличию такого потенциала на "цилиндре Венельта" фокусируется электронный пучок, выходящий из пушки. Второй электрод – анод (2), пластинка с отверстием в центре, через которое электронный пучок попадает в колонну микроскопа. Между нитью накала (катодом) и анодом приложено ускоряющее напряжение, обычно до 100 кВ. Как правило, имеется возможность ступенчато менять напряжение от 1 до 100 кВ.
Задача пушки – создание стабильного потока электронов при малой испускающей области катода. Чем меньше площадь, испускающая электроны, тем проще получить их тонкий параллельный пучок. Для этого применяют V-образные или специально остро заточенные катоды.
Далее в колонне микроскопа размещены линзы. Большинство современных электронных микроскопов имеют от четырех до шести линз. Выходящий из пушки электронный пучок направляется через пару конденсорных линз (5,6) на объект. Конденсорная линза позволяет в широких пределах изменять условия освещения объекта. Обычно конденсорные линзы представляют собой электромагнитные катушки, в которых токонесущие обмотки окружены (за исключением узкого канала диаметром около 2 – 4 см) сердечником из мягкого железа (рис.2) [3].
При изменении тока, протекающего через катушки, изменяется фокусное расстояние линзы, вследствие этого пучок расширяется или сужается, увеличивается или уменьшается площадь объекта, освещаемая электронами.
электронный микроскоп коррекция астигматизм
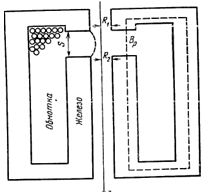
Рисунок 2 – Упрощенная схема магнитной электронной линзы
Обозначены геометрические размеры полюсного наконечника; штриховой линией показан контур, фигурирующий в законе Ампера. Штриховой линией показана так же линия магнитного потока, которая качественно определяет фокусирующее действие линзы. Вр – напряженность поля в зазоре вдали от оптической оси. На практике обмотки линзы имеют водяное охлаждение, а полюсный наконечник съемный
Чтобы получить большое увеличение, необходимо облучать объект потокам большой плотности. Конденсор (линза) обычно освещает площадь объекта, много большую интересующей нас при данном увеличении. Это может привести к перегреву образца и загрязнению его продуктами разложения масляных паров. Температуру объекта можно снизить, уменьшая приблизительно до 1 мкм облучаемую область с помощью второй конденсорной линзы, которая фокусирует изображение, образуемое первой конденсорной линзой. При этом увеличивается поток электронов через исследуемую площадь образца, повышается яркость изображения, образец меньше загрязняется.
Образец (объект) обычно помещают в специальный объектодержатель на тонкой металлической сетке диаметром 2 – 3 мм. Объектодержатель перемещается системой рычагов в двух взаимоперпендикулярных направлениях, наклоняется в разные стороны, что особенно важно при исследовании среза тканей либо таких дефектов кристаллической решетки, как дислокации и включения.

Рисунок 3 – Конфигурация полюсного наконечника высокоразрешающего объектива электронного микроскопа Siemens-102 [4].
В этой удачной промышленной конструкции диаметр отверстия верхнего полюсного наконечника 2R1=9 мм, диаметр отверстия нижнего полюсного наконечника 2R2=3 мм и межполюсный зазор S=5 мм (R1, R2 и S определены на рис.2): 1 – объектодержатель, 2 – столик образца, 3 – образец, 4 – объективная диафрагма, 5 – термисторы, 6 – обмотка линзы, 7 – верхний полюсный наконечник, 8 – охлаждаемый стержень, 9 – нижний полюсный наконечник, 10 – стигматор, 11 – каналы системы охлаждения, 12 – охлаждаемая диафрагма
В колонне микроскопа с помощью вакуумной системы откачки создается относительно низкое давление, примерно 10-5 мм рт. ст. На это уходит довольно много времени. Чтобы ускорить подготовку прибора к работе, к камере объектов присоединяется специальное устройство для быстрой смены объекта. В микроскоп при этом попадает лишь очень небольшое количество воздуха, которое удаляется вакуумными насосами. Смена образца обычно занимает 5 мин.
Изображение. При взаимодействии электронного пучка с образцом электроны, проходящие вблизи атомов вещества объекта, отклоняются в направлении, определяемом его свойствами. Этим главным образом и обусловлен видимый контраст изображения. Кроме того, электроны могут еще претерпеть неупругое рассеяние, связанное с изменением их энергии и направления, пройти через объект без взаимодействия или быть поглощенными объектом. При поглощения электронов веществом возникает световое или рентгеновское излучение либо выделяется тепло. Если образец достаточно тонок, то доля рассеянных электронов невелика. Конструкции современных микроскопов позволяют использовать для формирования изображения все эффекты, возникающие при взаимодействии электронного луча с объектом.
Электроны, прошедшие через объект, попадают в объективную линзу (9), предназначенную для получения первого увеличенного изображения. Объективная линза – одна из наиболее важных частей микроскопа, "ответственная" за разрешающую способность прибора. Эта связано с тем, что электроны входят под сравнительно большим углом наклона к оси и вследствие этого даже незначительные аберрации существенно ухудшают изображение объекта.
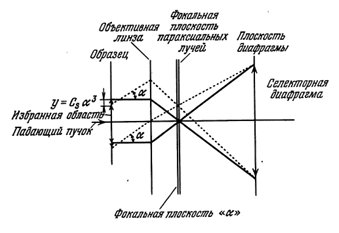
Рисунок 4 – Образование первого промежуточного изображения объективной линзой и эффект аберрации [5].
Окончательное увеличенное электронное изображение преобразуется в видимое посредством люминесцентного экрана, который светится под действием электронной бомбардировки. Это изображение, обычно слабоконтрастное, как правило, рассматривают через бинокулярный световой микроскоп. При той же яркости такой микроскоп с увеличением 10 может создавать на сетчатке глаза изображение, в 10 раз более крупное, чем при наблюдении невооруженным глазом. Иногда для повышения яркости слабого изображения применяется люминофорный экран с электронно-оптическим преобразователем. В этом случае окончательное изображение может быть выведено на обычный телевизионный экран, что позволяет записать его на видеоленту. Видеозапись применяется для регистрации изображений, меняющихся во времени, например, в связи с протеканием химической реакции. Чаще всего окончательное изображение регистрируется на фотопленке или фотопластинке. Фотопластинка обычно позволяет получить более четкое изображение, чем наблюдаемое простым глазом или записанное на видеоленте, так как фотоматериалы, вообще говоря, более эффективно регистрируют электроны. Кроме того, на единице площади фотопленки может быть зарегистрировано в 100 раз больше сигналов, чем на единице площади видеоленты. Благодаря этому изображение, зарегистрированное на фотопленке, можно дополнительно увеличить примерно в 10 раз без потери четкости.
Электронные линзы, как магнитные, так и электростатические, несовершенны. Они имеют те же дефекты, что и стеклянные линзы оптического микроскопа – хроматическая, сферическая аберрация и астигматизм. Хроматическая аберрация возникает из-за непостоянства фокусного расстояния при фокусировке электронов с различными скоростями. Эти искажения уменьшают, стабилизируя ток электронного луча и ток в линзах.
Сферическая аберрация обусловлена тем, что периферийные и внутренние зоны линзы формируют изображение на разных фокусных расстояниях. Намотку катушки магнита, сердечник электромагнита и канал в катушке, через который проходят электроны, нельзя выполнить идеально. Асимметрия магнитного поля линзы приводит к значительному искривлению траектории движения электронов.
Работа в режимах микроскопии и дифракции. Затененные области отмечают ход эквивалентных пучков в обоих режимах [5].
Если магнитное поле несимметрично, то линза искажает изображение (астигматизм). То же самое можно отнести и к электростатическим линзам. Процесс изготовления электродов и их центровка должны быть в высокой степени точны, ибо от этого зависит качество линз.
В большинстве современных электронных микроскопов нарушения симметрии магнитных и электрических полей устраняют с помощью стигматоров. В каналы электромагнитных линз помещают небольшие электромагнитные катушки, изменяя ток, протекающий через них, они исправляют поле. Электростатические линзы дополняют электродами: подбирая потенциал, удается компенсировать асимметрию основного электростатического поля. Стигматоры весьма тонко регулируют поля, позволяют добиваться высокой их симметрии.

Рисунок 5 – Ход лучей в электронном микроскопе просвечивающего типа
В объективе есть еще два важных устройства – апертурная диафрагма
и отклоняющие катушки. Если в формировании конечного изображения участвуют
отклоненные (дифрагированные) лучи, то качество изображения будет плохим
вследствие сферической аберрации линзы. В объективную линзу вводят апертурную
диафрагму с диаметром отверстия 40 – 50 мкм, которая задерживает лучи,
дифрагированные под углом более 0,5 градуса. Лучи, отклоненные на небольшой
угол, создают светлопольное изображение. Если апертурной диафрагмой
заблокировать проходящий луч, то изображение формируется дифрагированным лучом.
Оно в этом случае получается в темном поле. Однако метод темного поля дает
менее качественное изображение, чем светлопольный, поскольку изображение
формируется лучами, пересекающимися под углом к оси микроскопа, сферическая
аберрация и астигматизм проявляются в большей степени. Отклоняющие же катушки
служат для изменения наклона электронного луча. Для получения окончательного
изображения нужно увеличить первое увеличенное изображение объекта. Для этой
цели применяется проекционная линза. Общее увеличение электронного микроскопа
должно меняться в широких пределах, от небольшого соответствующего увеличению
лупы (![]() 10,
10, ![]() 20), при котором можно исследовать
не только часть объекта, но и увидеть весь объект, до максимального увеличения,
позволяющего наиболее полно использовать высокую разрешающую способность
электронного микроскопа (обычно до
20), при котором можно исследовать
не только часть объекта, но и увидеть весь объект, до максимального увеличения,
позволяющего наиболее полно использовать высокую разрешающую способность
электронного микроскопа (обычно до ![]() 200000).
Здесь уже недостаточно двухступенчатой системы (объектив, проекционная линза).
Современные электронные микроскопы, рассчитанные на предельную разрешающую
способность, должны иметь по крайней мере три увеличивающие линзы – объектив,
промежуточную и проекционную линзы. Такая система гарантирует изменение
увеличения в широком диапазоне (от
200000).
Здесь уже недостаточно двухступенчатой системы (объектив, проекционная линза).
Современные электронные микроскопы, рассчитанные на предельную разрешающую
способность, должны иметь по крайней мере три увеличивающие линзы – объектив,
промежуточную и проекционную линзы. Такая система гарантирует изменение
увеличения в широком диапазоне (от ![]() 10 до
10 до ![]() 200000).
200000).
Изменение увеличения осуществляется регулировкой тока промежуточной линзы.
Еще один фактор, способствующий получению большего увеличения, – изменение оптической силы линзы. Чтобы увеличить оптическую силу линзы, в цилиндрический канал электромагнитной катушки вставляют специальные так называемые "полюсные наконечники". Они изготовляются из мягкого железа или сплавов е большой магнитной проницаемостью и позволяют сконцентрировать магнитное поле в небольшом объеме. В некоторых моделях микроскопов предусмотрена возможность смены полюсных наконечников, таким образом добиваются дополнительного увеличения изображения объекта.
На конечном экране исследователь видит увеличенное изображение объекта. Различные участки объекта по-разному рассеивают падающие на них электроны. После объективной линзы (как уже указывалось выше) будут фокусироваться только электроны, которые при прохождении объекта отклоняются на малые углы. Эти же электроны фокусируются промежуточной и проекционной линзами на экране для конечного изображения. На экране соответствующие детали объекта будут светлые. В том случае, когда электроны при прохождении участков объекта отклоняются на большие углы, они задерживаются апертурной диафрагмой, расположенной в объективной линзе, и соответствующие участки изображения будут на экране темными.
Изображение становится видимым на флюоресцентном экране (светящимся под действием падающих на него электронов). Фотографируют его либо на фотопластинку, либо на фотопленку, которые расположены на несколько сантиметров ниже экрана. Хотя пластинка помещается ниже экрана, благодаря тому что электронные линзы имеют довольно большую глубину резкости и фокуса, четкость изображения объекта на фотопластинке не ухудшается. Смена пластинки – через герметичный люк. Иногда применяют фотомагазины (от 12 до 24 пластинок), которые устанавливают также через шлюзовые камеры, что позволяет избежать разгерметизации всего микроскопа.
Разрешение. Электронные пучки имеют свойства, аналогичные свойствам световых пучков. В частности, каждый электрон характеризуется определенной длиной волны. Разрешающая способность электронного микроскопа определяется эффективной длиной волны электронов. Длина волны зависит от скорости электронов, а следовательно, от ускоряющего напряжения; чем больше ускоряющее напряжение, тем больше скорость электронов и тем меньше длина волны, а значит, выше разрешение. Столь значительное преимущество электронного микроскопа в разре-
шающей способности объясняется тем, что длина волны электронов намного меньше длины волны света. Но поскольку электронные линзы не так хорошо фокусируют, как оптические (числовая апертура хорошей электронной линзы составляет всего лишь 0,09, тогда как для хорошего оптического объектива эта величина достигает 0,95), разрешение электронного микроскопа равно 50 – 100 длинам волн электронов. Даже со столь слабыми линзами в электронном микроскопе можно получить предел разрешения около 0,17 нм, что позволяет различать отдельные атомы в кристаллах. Для достижения разрешения такого порядка необходима очень тщательная настройка прибора; в частности, требуются высокостабильные источники питания, а сам прибор (который может быть высотой около 2,5 м и иметь массу в несколько тонн) и его дополнительное оборудование требуют монтажа, исключающего вибрацию.
Для достижения разрешения по точкам лучше чем 0,5 нм необходимо поддерживать прибор в отличном состоянии и, кроме того, использовать микроскоп, который специально предназначен для работ, связанных с получением высокого разрешения. Нестабильность тока объективной линзы и вибрации объектного столика следует свести к минимуму. Исследователь должен быть уверен, что в полюсном наконечнике объектива отсутствуют остатки объектов, оставшихся от предыдущих исследований. Диафрагмы должны быть чистыми. Микроскоп следует устанавливать в месте, удовлетворительном с точки зрения вибраций, посторонних магнитных полей, влажности, температуры и пыли. Постоянная сферической аберрации должна быть меньше 2 мм. Однако самыми важными факторами при работе с высоким разрешением являются стабильность электрических параметров и надежность микроскопа. Скорость загрязнения объекта должна быть меньше, чем 0,1 нм/мин, и это особенно важно для работы с высоким разрешением в темном поле.
Температурный дрейф должен быть минимальным. Для того чтобы свести к минимуму загрязнение и максимально увеличить стабильность высокого напряжения, необходим вакуум причем его следует измерять в конце линии откачки. Внутренность микроскопа, в особенности объем камеры электронной пушки, должны быть скрупулезно чистыми.
Удобными объектами для проверки микроскопа являются тест-объекты с маленькими частичками частично графитизированного угля, в которых видны плоскости кристаллической решетки. Во многих лабораториях такой образец всегда держат под рукой, чтобы проверять состояние микроскопа, и каждый день, прежде чем начать работу с высоким разрешением, на этом образце получают четкие изображения системы плоскостей с межплоскостным расстоянием 0,34 нм, используя держатель образца без наклона. Такая практика проверки прибора настоятельно рекомендуется. Больших затрат времени и энергии требует поддержание микроскопа в наилучшем состоянии. Не следует планировать исследования, требующие высокого разрешения, до тех пор пока не обеспечено поддержание состояния прибора на соответствующем уровне, и, что еще более важно, до тех пор пока микроскопист не вполне уверен, что результаты, полученные с помощью изображений высокого разрешения, оправдают затраченные время и усилия.
Современные электронные микроскопы оборудуются рядом приспособлений. Весьма важна приставка для изменения наклона образца во время наблюдения (гониометрическое устройство). Так как контраст изображения получается главным образом за счет дифракции электронов, то даже малые наклоны образца могут существенно влиять на него. Гониометрическое устройство имеет две взаимно перпендикулярные оси наклона, лежащие в плоскости образца, и приспособленные для его вращения на 360°. При наклоне устройство обеспечивает неизменность положения объекта относительно оси микроскопа. Гониометрическое устройство также необходимо при получении стереоснимков для изучения рельефа поверхности излома кристаллических образцов, рельефа костных тканей, биологических молекул и т. п.
Стереоскопическая пара получается съемкой в электронном микроскопе одного и того же места объекта в двух положениях, когда он повернут на небольшие углы к оси объектива (обычно ±5°).
Интересная информация об изменении структуры объектов может быть получена при непрерывном наблюдении за нагревом объекта. С помощью приставки удается изучить поверхностное окисление, процесс разупорядочения, фазовые превращения в многокомпонентных сплавах, термические превращения некоторых биологических препаратов, провести полный цикл термической обработки (отжиг, закалка, отпуск), причем с контролируемыми высокими скоростями нагрева и охлаждения. Вначале были разработаны устройства, которые герметично присоединялись к камере объектов. Специальным механизмом объект извлекался из колонны, термообрабатывался, а затем вновь помещался в камеру объектов. Преимущество метода – отсутствие загрязнения колонны и возможность длительной термообработки.
В современных электронных микроскопах имеются устройства для нагревания объекта непосредственно в колонне. Часть объектодержателя окружена микропечью. Нагрев вольфрамовой спирали микропечек осуществляется постоянным током от небольшого источника. Температура объекта изменяется при изменении тока нагревателя и определяется по градуировочной кривой. В устройстве сохраняется высокое разрешение при нагреве вплоть до 1100°С – порядка 30 Å.
В последнее время разработаны устройства, позволяющие нагревать объект электронным пучком самого микроскопа. Объект располагается на тонком вольфрамовом диске. Диск нагревается расфокусированным электронным лучом, небольшая часть которого проходит через отверстие в диске и создает изображение объекта. Температуру диска можно менять в широких пределах, изменяя его толщину и диаметр электронного луча.
Есть в микроскопе и столик для наблюдения объектов в процессе охлаждения до –140° С. Охлаждение – жидким азотом, который заливается в сосуд Дьюара, соединенный со столиком специальным хладопроводом. В этом устройстве удобно исследовать некоторые биологические и органические объекты, которые без охлаждения под воздействием электронного луча разрушаются.
С помощью приставки для растяжения объекта можно исследовать движение дефектов в металлах, процесс зарождения и развития трещины в объекте. Создано несколько типов подобных устройств. В одних использовано механическое нагружение перемещением захватов, в которых крепится объект, или передвижением нажимного стержня, в других – нагрев биметаллических пластин. Образец приклеивается или крепится захватами к биметаллическим пластинам, которые расходятся в стороны, когда их нагревают. Устройство позволяет деформировать образец на 20% и создавать усилие в 80 г.
Самой важной приставкой электронного микроскопа можно считать микродифракционное устройство для электронографических исследований какого-либо определенного участка объекта, представляющего особый интерес. Причем микродифракционную картину на современных микроскопах получают без переделки прибора. Дифракционная картина состоит из серии либо колец, либо пятен. Если в объекте многие плоскости ориентированы благоприятным для дифракции образом, то изображение состоит из сфокусированных пятен. Если электронный луч попадает сразу на несколько зерен беспорядочно ориентированного поликристалла, дифракция создается многочисленными плоскостями, образуется картина из дифракционных колец. По местоположению колец или пятен можно установить структуру вещества (например, нитрид или карбид), его химический состав, ориентацию кристаллографических плоскостей и расстояние между ними.
2.1 Источники электронов
Обычно используются четыре типа источников электронов: вольфрамовые V-образные катоды, вольфрамовые точечные (острийные) катоды, источники из гексаборида лантана и автоэлектронные источники. В данной главе кратко рассматриваются преимущества каждого вида источника электронов для просвечивающей электронной микроскопии высокого разрешения и их характеристики. К источникам электронов, используемым в электронной микроскопии высокого разрешения, предъявляются следующие основные требования:
1. Высокая яркость (плотность тока на единицу телесного угла). Выполнение этого требования существенно для экспериментов при получении изображений высокого разрешения с фазовым контрастом, когда необходимо сочетать малую апертуру освещения с достаточной величиной плотности тока, что дает возможность точно фокусировать изображение при большом увеличении.
2. Высокая эффективность использования электронов (отношение яркости к полной величине тока первичного пучка электронов), которая достигается за счет малого размера источника. Уменьшение освещаемой области образца снижает его нагревание и тепловой дрейф в процессе экспозиции.
3. Большое время жизни при имеющемся вакууме.
4. Стабильная эмиссия при длительной (до минуты) экспозиции, характерной в микроскопии высокого разрешения.
Идеальной системой освещения для обычного просвечивающего микроскопа высокого разрешения была бы система, позволяющая оператору независимо контролировать размер освещаемой области образца, интенсивность освещения и когерентность пучка. Такие возможности достигаются только при работе с автоэлектронным источником. Однако для большинства лабораторий использование вольфрамового точечного катода является наилучшим компромиссом, приемлемым как по стоимости, так и по рабочим характеристикам для просвечивающей микроскопии высокого разрешения. В настоящее время рассматривается также возможность использования источников из гексаборида лантана. Перспективным является также катод, нагреваемый лучом лазера, яркость которого, как сообщается, в 3000 раз превосходит яркость V-образного катода при эффективном диаметре источника порядка 10 нм. Эти катоды работают при умеренном вакууме (10-4 Тор).
2.2. Система освещения

Образец
Рисунок 6 – Осветительная система современного электронного микроскопа
Система имеет две конденсорные линзы С1 (сильная линза) и С2 (слабая линза). F – катод; W – цилиндр Вепельта; S – мнимый источник электронов, S' и S" – его изображения; СА2 – вторая конденсорная диафрагма. Расстояния U1, U2, V1, V2 являются электронно-оптическими параметрами, тогда как расстояния D1, D2, D3 легко измеряются в колонне микроскопа. [4].
На рис. 6 представлены две конденсорные линзы, входящие в систему освещения электронного микроскопа. Обычно можно осуществить независимое изменение фокусного расстояния этих линз (С1 и С2). Возбуждение первой конденсорной линзы изменяют с помощью регулировочной ручки, называемой иногда "размер пятна". Обычно выбирается такое возбуждение, при котором плоскости S, S' и поверхность образца являются сопряженными, т. е. чтобы сфокусированное изображение источника формировалось на образце (сфокусированное освещение).
Для V-образного катода размер источника приблизительно равен 30 мкм. Для предотвращения нежелательного нагрева и радиационного повреждения образца на нем нужно сформировать уменьшенное изображение источника. Рабочее расстояние D3 также должно быть достаточно большим, чтобы имелась возможность перемещения объектодержателя при смене образца. При использовании одной конденсорной линзы трудно удовлетворить этим противоречивым требованиям – малое увеличение при большом расстоянии D3 – так как для этого необходимо, чтобы расстояние D1 было чрезмерно большим. Поэтому обычно используется сильная первая конденсорная линза С1, служащая для уменьшения изображения источника в 5 – 100 раз, а следующая за первой вторая слабая линза С2 с увеличением около 3 обеспечивает большое рабочее расстояние,
2.3 Коррекция астигматизма
Регулировка стигматора объективной линзы весьма критична для обеспечения высокого разрешения. В некоторых приборах астигматизм регулируется как по направлению, так и по силе, в то время как в других предусмотрена регулировка силы астигматизма в двух фиксированных ортогональных направлениях. Прежде всего следует грубо скорректировать астигматизм с помощью стигматора до получения симметричности кольца Френеля. При работе с высоким разрешением необходимо возможно более точно скорректировать астигматизм, что можно сделать по изображению структуры тонкой аморфной угольной пленки при большом увеличении. Для тщательной корректировки астигматизма на деталях такого изображения размером 0,3 нм необходимы увеличение микроскопа по крайней мере 400 000-кратное и оптический бинокуляр х10. С помощью ручек изменения фокуса и стигма-тора добейтесь минимального контраста, что достигается при использовании ручек наиболее тонкой регулировки. При недофокусировке объектива в несколько десятков нанометров должна быть видна однородная зернистая структура угольной пленки без анизатропии в каком-либо преимущественном направлении. Это – трудная процедура, требующая значительных навыков. Оптическая дифрактограмма позволяет наиболее быстро проверить правильность коррекции астигматизма, и ее использование особенно важно при освоении процедуры корректировки астигматизма. Важны следующие моменты:
1. Глаза должны полностью адаптироваться к темноте. Для этого необходимо провести по крайней мере 20 мин в темноте.
2. Положение и чистота находящихся в поле линзы объективной диафрагмы и охлаждаемой диафрагмы критически влияют на требуемую установку стигматора. Никогда не трогайте ни ту, ни другую диафрагму после корректировки астигматизма до фотографирования изображения. Самое важное, что астигматизм не меняется во времени и его можно скорректировать. Небольшие загрязнения объективной диафрагмы не создают помех, которые нельзя скорректировать с помощью стигматора. Грязная диафрагма, создающая флуктуации поля, является более серьезной помехой. Проверяйте степень загрязнения диафрагмы объектива, смещая ее во время наблюдения изображения. При небольших смещениях диафрагмы не должно наблюдаться сильное ухудшение астигматизма. Чистоту отверстия охлаждаемой диафрагмы можно проверить при том увеличении, при котором она ограничивает поле зрения. Проверку производят небольшим перемещением охлаждаемой диафрагмы, если это возможно, проводя наблюдение при малом увеличении.
3. Ток коррекции астигматизма изменяется в зависимости от типа используемого объектодержателя, ускоряющего напряжения и тока возбуждения объективной линзы. Последний слегка зависит от увеличения, возможно, из-за магнитного взаимодействия линз.
4. Часто встречающейся причиной сильного астигматизма является присутствие кусочка от расколовшегося или частично испарившегося образца в полюсном наконечнике объектива.
5. Нет смысла корректировать астигматизм до тех пор, пока охлаждаемая диафрагма не достигнет температуры жидкого азота и пока резервуар охлаждаемой диафрагмы приходится периодически доливать жидким азотом (лучше с помощью насоса). Астигматизм также быстро появляется, как только жидкий азот испаряется из резервуара, приводя к перемещению диафрагмы по мере ее нагрева. На стабилизацию температуры диафрагмы может потребоваться по крайней мере полчаса с момента начала заполнения резервуара.
О чувствительности изображений высокого разрешения к астигматизму можно судить, проводя наблюдение плоскостей графитизированного углерода в светлом поле с ненаклоненным освещением и при этом регулируя стигматор. Чтобы получить изображения плоскостей решетки, расположенных во всевозможных направлениях, нужно точно скомпенсировать астигматизм по двум направлениям. Легче получить изображение плоскостей решетки одного направления, но оно не обеспечивает контроля точной коррекций астигматизма.
Наконец стоит повторить, что астигматизм нужно корректировать после каждого перемещения диафрагмы объектива.
2.4 Вспомогательное оборудование для обычной просвечивающей электронной микроскопии высокого разрешения
Кроме самого микроскопа имеются различные вспомогательные устройства, дополняющие микроскоп, которые упоминались ранее в настоящей книге. В совокупности все они освещаются в этом параграфе.
1. Масс-спектрометр или манометр парциального давления являются чрезвычайно полезным дополнением к электронному микроскопу. Масс-спектрометр дает полный анализ продуктов загрязнения в микроскопе. В конструкциях некоторых приборов имеются магниты, такой прибор следует располагать с учетом возможного влияния на электронно-микроскопическое изображение.
2. Работая с высоким разрешением, полезно пользоваться балонным осушенным азотом. Микроскоп наполняется сухим азотом всякий раз, когда необходим внутренний ремонт для того, чтобы уменьшить количество водяных паров, проникающих в колонну.
3. Для калибровки увеличения прибора в условиях изменяющейся длины фокуса объективной линзы полезно использовать прибор для измерения тока объективной линзы.
4. Ввиду важности обеспечения термической стабильности при фотографировании темнопольных изображений с длительными экспозициями целесообразно иметь насос для перекачки жидкого азота.
5. Для сдувания с образца пыли или следов средств, оставшихся после чистки камеры пушки микроскопа, всегда полезно иметь резиновую грушу с соплом.
3. ПРИМЕНЕНИЕ ПРОСВЕЧИВАЮЩЕГО ЭЛЕКТРОННОГО МИКРОСКОПА
Вряд ли остался какой-либо сектор исследований в области биологии и материаловедения, где бы не применялась просвечивающая электронная микроскопия (ПЭМ); это обеспечено успехами техники приготовления образцов.
Все применяемые в электронной микроскопии методики нацелены на получение предельно тонкого образца и обеспечение максимального контраста между ним и подложкой, которая необходима ему в качестве опоры. Основная методика рассчитана на образцы толщиной 2 – 200 нм, поддерживаемые тонкими пластмассовыми или углеродными пленками, которые кладутся на сетку с размером ячейки около 0,05 мм. (Подходящий образец, каким бы способом он ни был получен, обрабатывается так, чтобы увеличить интенсивность рассеяния электронов на исследуемом объекте.) Если контраст достаточно велик, то глаз наблюдателя может без напряжения различить детали, находящиеся на расстоянии 0,1 – 0,2 мм друг от друга. Следовательно, для того, чтобы на изображении, создаваемом электронным микроскопом, были различимы детали, разделенные на образце расстоянием в 1 нм, необходимо полное увеличение порядка 100 – 200 тыс. Лучшие из микроскопов могут создать на фотопластинке изображение образца с таким увеличением, но при этом изображается слишком малый участок. Обычно делают микроснимок с меньшим увеличением, а затем увеличивают его фотографически. Фотопластинка разрешает на длине 10 см около 10 000 линий. Если каждая линия соответствует на образце некой структуре протяженностью 0,5 нм, то для регистрации такой структуры необходимо увеличение не менее 20 000, тогда как при помощи ПЭМ, может быть разрешено около 1000 линий.
3.1 Небиологические материалы
Главной целью электронной микроскопии высокого разрешения на сегодняшний день является визуализация деталей ультраструктуры несовершенных кристаллических материалов. В настоящее время не существует других методов, способных давать такую информацию на атомном уровне разрешения или на уровне разрешения элементарной ячейки. Детальное понимание структуры дефектов кристаллов определяет прогресс как в кристаллохимии, так и в области исследования прочности материалов. Используя электронный пучок для управления скоростью протекания химической реакции в кристаллах, можно также почти на атомном уровне изучать движение дефектов при фазовых переходах. Электронная микроскопия высокого разрешения- находит также широкое применение для исследования микроструктуры очень маленьких кристаллов, от которых нельзя получить картину рентгеновской дифракции. В последние годы этот метод широко применяется для исследования минералов и керамических материалов.
Исследования минералов методом реплик начались несколько десятков лет назад. Непосредственно методом просвечивающей электронной микроскопии первыми были изучены слюда и глинистые минералы. Среди первых минералогов, которые использовали электронную микроскопию в своих исследованиях, можно назвать Риббе, Мак-Коннела и Флита [5]. Большое влияние на развитие электронной микроскопии применительно к минералогии оказали работы Мак-Ларена и Фейки (с 1965 г.) и Ниссена (с 1967 г.); программа их исследований была целиком посвящена электро-микроскопическому исследованию минералов. В 1970 г. работы по исследованию лунных материалов методами ТЭМ способствовали возникновению необыкновенного бума в электронной микроскопии минералов, в который наряду с минералогами были вовлечены материаловеды и физики. Полученные ими в течение пяти лет результаты, оказавшие колоссальное влияние на современную минералогию, показали, что электронная микроскопия является очень мощным инструментом в руках ученого. К настоящему времени новые данные внесли весомый вклад в расшифровку строения полевых шпатов и пироксенов, и почти в каждой группе минералов исследования с помощью электронной микроскопии раскрывают ряд неожиданных свойств.
Электронная микроскопия применялась также для определения возраста земных, лунных и метеоритных пород. При этом было использовано то обстоятельство, что во время радиоактивного распада ядра высвобождаются частицы, проникающие в окружающий материал с высокой скоростью и оставляющие видимый "след" в кристалле. Такие треки можно увидеть с помощью электронного микроскопа, используя его в режимах сканирования или на просвет. Плотность треков распада вокруг радиоактивного включения пропорциональна возрасту кристалла, а их длина является функцией энергии частицы. Длинные треки, указывающие на высокую энергию частиц, были обнаружены вокруг включений витлокита в лунной породе; Хатчеон и Прайс приписали этот необычайно длинный трек распаду элемента 244Ро, который из-за короткого периода полураспада к настоящему времени исчез, но еще мог существовать 4 млрд. лет назад. Треки в материале, взятом с поверхности Луны или из метеоритов (рис. 7) [5], дают информацию об эволюции космической радиации и позволяют сделать выводы о возрасте и составе Вселенной.
Высокая плотность треков вызвана наличием энергетически более тяжелых ядер (главным образом Fе) в солнечной вспышке перед образованием метеорита. Примечательна таблитчатчатая структура, обусловленная распадом твердых растворов.

Рисунок 7 – Темнопольная ТЭМ-картина зерна пироксена из метеорита Пезиано
ПЭМ применяется в исследованиях материалов для изучения тонких кристаллов и границ между разными материалами. Чтобы получить изображение границы раздела с большим разрешением, образец заливают пластмассой, делают срез образца, перпендикулярный границе, а затем утоньшают его так, чтобы граница была видна на заостренной кромке. Кристаллическая решетка сильно рассеивает электроны в определенных направлениях, давая дифракционную картину. Изображение кристаллического образца в значительной мере определяется этой картиной; контраст сильно зависит от ориентации, толщины и совершенства кристаллической решетки. Изменения контраста на изображении позволяют изучать кристаллическую решетку и ее несовершенства в масштабе атомных размеров. Получаемая при этом информация дополняет ту, которую дает рентгенографический анализ объемных образцов, так как ЭМ дает возможность непосредственно видеть во всех деталях дислокации, дефекты упаковки и границы зерен. Кроме того, в ЭМ можно снимать электронограммы и наблюдать картины дифракции от выделенных участков образца. Если диафрагму объектива настроить так, чтобы через нее проходили только один дифрагированный и нерассеянный центральный пучки, то можно получать изображение определенной системы кристаллических плоскостей, которая дает этот дифрагированный пучок. Современные приборы позволяют разрешать периоды решетки величиной 0,1 нм. Исследовать кристаллы можно также методом темнопольного изображения, при котором перекрывают центральный пучок, так что изображение формируется одним или несколькими дифрагированными пучками. Все эти методы дали важную информацию о структуре очень многих материалов и существенно прояснили физику кристаллов и их свойства. Например, анализ ПЭМ-изображений кристаллической решетки тонких малоразмерных квазикристаллов в сочетании с анализом их электронограмм позволил в 1985 открыть материалы с симметрией пятого порядка.
3.2 Биологические препараты
Электронная микроскопия широко применяется в биологических и медицинских исследованиях. Разработаны методики фиксации, заливки и получения тонких срезов тканей для исследования в ОПЭМ. Эти методики дают возможность исследовать организацию клеток на макромолекулярном уровне. Электронная микроскопия выявила компоненты клетки и детали строения мембран, митохондрий, эндоплазматической сети, рибосом и множества других органелл, входящих в состав клетки. Образец сначала фиксируют глутаральдегидом или другими фиксирующими веществами, а затем обезвоживают и заливают пластмассой. Методы криофиксации (фиксации при очень низких – криогенных – температурах) позволяют сохранить структуру и состав без использования химических фиксирующих веществ. Кроме того, криогенные методы позволяют получать изображения замороженных биологических образцов без их обезвоживания. При помощи ультрамикротомов с лезвиями из полированного алмаза или сколотого стекла можно делать срезы тканей толщиной 30 – 40 нм. Смонтированные препараты могут быть окрашены соединениями тяжелых металлов (свинца, осмия, золота, вольфрама, урана) для усиления контраста отдельных компонентов или структур.
Биологические исследования были распространены на микроорганизмы, особенно на вирусы, которые не разрешаются световыми микроскопами. ПЭМ позволила выявить, например, структуры бактериофагов и расположение субъединиц в белковых оболочках вирусов. Кроме того, методами позитивного и негативного окрашивания удалось выявить структуру с субъединицами в ряде других важных биологических микроструктур. Методы усиления контраста нуклеиновых кислот позволили наблюдать одно- и двунитные ДНК. Эти длинные линейные молекулы распластывают в слой основного белка и накладывают на тонкую пленку. Затем на образец вакуумным напылением наносят очень тонкий слой тяжелого металла. Этот слой тяжелого металла "оттеняет" образец, благодаря чему последний при наблюдении в ОПЭМ выглядит как бы освещенным с той стороны, с которой напылялся металл. Если же вращать образец во время напыления, то металл накапливается вокруг частиц со всех сторон равномерно (как снежный ком).
3.3 Высоковольтная микроскопия
В настоящее время промышленность выпускает высоковольтные варианты ОПЭМ с ускоряющим напряжением от 300 до 400 кВ. Такие микроскопы имеют более высокую проникающую способность, чем у низковольтных приборов, причем почти не уступают в этом отношении микроскопам с напряжением 1 млн. вольт, которые строились в прошлом. Современные высоковольтные микроскопы достаточно компактны и могут быть установлены в обычном лабораторном помещении. Их повышенная проникающая способность оказывается очень ценным свойством при исследовании дефектов в более толстых кристаллах, особенно таких, из которых невозможно сделать тонкие образцы. В биологии их высокая проникающая способность дает возможность исследовать целые клетки, не разрезая их. Кроме того, с помощью таких микроскопов можно получать объемные изображения толстых объектов.
3.4 Радиационное повреждение
Поскольку электроны представляют собой ионизирующее излучение, образец в ЭМ постоянно подвергается его воздействию. Следовательно, образцы всегда подвергаются радиационному повреждению. Типичная доза излучения, поглощаемая тонким образцом за время регистрации микрофотографии в ОПЭМ, примерно соответствует энергии, которой было бы достаточно для полного испарения холодной воды из пруда глубиной 4 м с площадью поверхности 1 га. Чтобы уменьшить радиационное повреждение образца, необходимо использовать различные методы его подготовки: окрашивание, заливку, замораживание. Кроме того, можно регистрировать изображение при дозах электронов, в 100 – 1000 раз меньших, нежели по стандартной методике, а затем улучшать его методами компьютерной обработки изображений.
4. СОВРЕМЕННЫЕ ВИДЫ ПЭМ
Просвечивающий электронный микроскоп Titan 80 – 300 с атомным разрешением

Современный просвечивающий электронный микроскоп Titan™ 80 – 300 дает изображение наноструктур на суб-ангстремном уровне. Электронный микроскоп Титан работает в диапазоне 80 – 300 кВ с возможностями коррекции сферической аберрации и монохроматичности. Данный электронный микроскоп соответствует жестким требованиям максимальной механической, тепловой и электрической стабильности, так же, как точным юстировкам усовершенствованных компонентов. Титан расширяет разрешающие возможности спектроскопии при измерении запрещенных энергетических зон и электронных свойств и позволяет пользователю получить четкие изображения границ раздела и наиболее полно интерпретировать полученные данные.
JEOL JEM – 3010
300 кВ просвечивающий электронный микроскоп
300-киловольтный аналитический электронный микроскоп высокой точности и сверхвысокого разрешения сконструирован таким образом, чтобы одновременно можно было наблюдать изображение на атомарном уровне и прицельно анализировать образец. В данном микроскопе использовано много новых разработок, в том числе компактная электронная пушка на 300 кВ, осветительная система с пятью линзами.
Использование встроенного ионного насоса обеспечивает чистый и стабильно высокий вакуум.

· Разрешение по точкам: 0,17 нм
· Ускоряющее напряжение: от 100 до 300 кВ
Увеличение:
от ![]() 50 до
50 до ![]() 1 500 000
1 500 000
JEOL JEМ – 3000FasTEM
300 кВ просвечивающий электронный микроскоп с полевой эмиссией

Просвечивающий электронный микроскоп, оборудованный электронной пушкой высокой яркости с подогревным катодом на полевой эмиссии, обладающим повышенной стабильностью тока эмиссии. Позволяет непосредственно наблюдать детали атомного строения и анализировать отдельные атомные слои. Электронная пушка с подогревным катодом на полевой эмиссии, более всего подходящая для анализа нанообластей, обеспечивает ток зонда 0,5 нА при его диаметре 1 нм и 0,1 нА при 0,4 нм.
· Разрешение в точке: 0,17 нм
· Ускоряющее напряжение: 100, 200, 300 кВ
Увеличение: от х60 до х1 500 000
JEOL JEМ – 2100F
200 кВ просвечивающий электронный микроскоп с полевой эмиссией

Электронная пушка с полевой эмиссией, обеспечивающая электронный пучок с высокой яркостью и когерентностью, играет ключевую роль в получении высокого разрешения и при анализе наноструктур. Прибор JEM – 2100F является комплексным ПЭМ, оснащенным развитой системой электронного управления различными функциями.
Основные особенности данного прибора:
· Высокая яркость и стабильность электронной пушки с термополевой эмиссией обеспечивает анализ областей наноразмеров при большом увеличении.
· Диаметр зонда меньше 0.5 нм позволяет уменьшить точку анализа до уровня нанометров.
· Новый высокостабильный столик образцов с боковой загрузкой обеспечивает простой наклон, поворот, нагрев и охлаждение, программируемые установки и другое без механического дрейфа.
JEOL JEМ – 2100 LaB6
200 кВ аналитический просвечивающий электронный микроскоп
Позволяет не только получать изображения на просвет и картины дифракции, но и включает в себя компьютерную систему контроля, которая может объединять TEM , устройство получения изображений в режиме сканирования (STEM), энергодисперсионный спектрометр (JED – 2300 T) и спектрометр энергетических потерь электронов (EELS) в любых комбинациях.

Высокое разрешение (0,19 нм при 200 kV на катоде LaB 6 ) достигается благодаря стабильности высокого напряжения и тока пучка, вместе с превосходной системой линз. Новая структура рамы колонны микроскопа мягко уменьшает эффект вибрации прибора. Новый гониометрический столик позволяет позиционирование образца с точностью до нанометров. Компьютерная система контроля микроскопа обеспечивает подключение по сети других пользователей (компьютеров) и обмен информацией между ними.
ЗАКЛЮЧЕНИЕ
До сравнительно недавнего времени в руках минералогов находились два классических инструмента – поляризационный микроскоп и аппаратура для рентгеновской дифракции. С помощью оптического микроскопа мы можем исследовать морфологию и оптические свойства минералов, изучать двойники и ламели, если они по размеру превышают длину волны падающего света. Данные по рентгеновской дифракции позволяют точно определить положение атомов в элементарной ячейке в масштабе 1 – 100 Å. Однако такое определение кристаллического строения дает нам некую структуру, усредненную по многим тысячам элементарных ячеек; следовательно, мы заранее принимаем, что все элементарные ячейки идентичны.
В то же время становится все более очевидной важность структурных деталей, характеризующих минералы в масштабе 100 – 10 000 Å. Диффузные рефлексы на рентгенограммах были интерпретированы как свидетельство существования малых доменов; астеризм, наблюдаемый на лауэграммах, или небольшие значения коэффициентов экстинкции при уточнении структуры, указали на то, что кристаллы несовершенны по своему строению и содержат различные дефекты. Для исследования неоднородностей, размеры которых находятся в указанных пределах, идеальным инструментом является электронный микроскоп. Такие исследования – важный источник геологической информации, характеризующей параметры охлаждения и образования минералов и горных пород или условия их деформации.
В противоположность рентгеновской дифракции, которую начали использовать в минералогии немедленно после ее открытия, электронная микроскопия вначале получила наибольшее развитие и применение в металлургии. После создания промышленных приборов в 1939 г. потребовалось более 30 лет, чтобы электронный микроскоп стал обычным инструментом в минералогии и петрографии.
Преимущество электронной микроскопии состоит в том, что с ее помощью структуры и текстуры можно изобразить в реальном пространстве, и, следовательно, результаты легче визуализировать, чем получить их путем расчета дифракционных картин. Здесь уместно упомянуть о необходимости соблюдать определенную осторожность. В отличие от наблюдений в оптическом микроскопе структуру нельзя увидеть непосредственно через электронный микроскоп. Мы просто наблюдаем контраст, возникающий, например, от поля деформаций вокруг дислокаций, и этот контраст трансформируется в изображение внутри прибора. Электронная микроскопия не заменяет исследований, проводимых методами рентгеновской дифракции. С другой стороны, имеется много примеров, когда данные электронной микроскопии служили основанием для интерпретации рентгеновских данных. Эти две методики идеально дополняют друг друга.
СПИСОК ЛИТЕРАТУРЫ
1 Дюков В.Г., Непийко С.А., Седов Н.Н Электронная микроскопия локальных потенциалов./ АН УССР. Ин-т физики. – Киев: Наук. думка, 1991. – 200 с.
2 Кулаков Ю.А Электронная микроскопия. – М.: Знание,1981. – 64 с.
3 Ч. Пул, Ф. Оуэнс Нанотехнологии: Пер. с англ./Под ред. Ю. И. Головина. – М.: Техносфера, 2005. – 336 с
4 Спенс Дж. Экспериментальная электронная микроскопия высокого разрешения: Пер. с англ./Под ред. В. Н. Рожанского. – М.: Наука. Гл. ред. физ.-мат. Лит.,1986. – 320 с., ил.
5 Томас Г., Горинж М. Дж. Просвечивающая электронная микроскопия материалов: Пер. с англ./Под ред. Б.К. Вайнштейна – М: Наука. Главная редакция физико-математической литературы, 1983 – 320с
6 Электронная микроскопия в минералогии: Пер. с анг./Под общей ред. Г.-Р. Венка. – М.: Мир, 1979. – 485с., ил.
| Растровый электронный микроскоп | |
|
Содержание Введение 1 Электронно-микроскопический метод исследования 2 Физические основы растровой электронной микроскопии 2.1 Разновидности ... Применение просвечивающей электронной микроскопии (ПЭМ) в минералогии началось со времени получения теневых изображений тонкодисперсных частиц глинистых минералов. Электронный пучок, сфокусированный на поверхности образца, вызывает появление отраженных, вторичных и поглощенных электронов, которые используются для получения изображения ... |
Раздел: Рефераты по физике Тип: курсовая работа |
| Электронная микроскопия | |
|
БЕЛОРУССКИЙ ГОСУДАРСТВЕННЫЙ УНИВЕРСИТЕТ ИНФОРМАТИКИ И РАДИОЭЛЕКТРОНИКИ Кафедра ЭТТ РЕФЕРАТ На тему: "Электронная микроскопия" МИНСК, 2008 Основные ... 1). Вдоль центральной оси этой колонны сверху вниз внутри колонны расположены электронный прожектор, определенный набор электрических катушек с проводом - электрических магнитов ... 1 - термоэмиссионный катод; 2 - управляющий электрод; 3 - анод, 4 - ЭЛТ для наблюдения; 5 - ЭЛТ для фотографирования; 6,7 - первая и вторая конденсорная линзы; 8 - отклоняющие ... |
Раздел: Рефераты по коммуникации и связи Тип: реферат |
| Анализ и моделирование методов когерентной оптики в медицине и ... | |
|
Введение Когерентная оптика может выполнять два типа операции в биологии и медицине. Во-первых, она может производить операции, которые можно ... Например, неудовлетворительная коррекция линз в обычной микроскопии лимитирует качество изображения. Редмен снова был среди пионеров, решавших эту проблему как для изображений, получаемых с помощью электронного микроскопа [1.46], так и для рентгеновских изображений [1.47]. |
Раздел: Рефераты по физике Тип: дипломная работа |
| Кристаллы в природе | |
|
Содержание ВВЕДЕНИЕ 3 Тепловые и механические свойства твёрдых тел I. Симметрия кристаллов 1.1 Как растут кристаллы 5 1.2 Идеальная форма кристаллов 7 ... Пучок монохроматических рентгеновских лучей падает на образец из спрессованного поликристаллического вещества и рассевается атомными плоскостями кристалла в виде системы ... Эту область пространства можно изобразить в виде электронного облака, которое гуще там, где электрон бывает чаще, т.е. где больше вероятность пребывания электрона (рис 11). |
Раздел: Рефераты по физике Тип: реферат |
| Метрологические испытания измерительного микроскопа ТМ-500 | |
|
СОДЕРЖАНИЕ Введение 1. Общие положения испытаний средств измерений 2. Структурная схема и принцип действия микроскопа 3. Инструкция по использованию ... Заявитель - ОАО "УРАЛаз" предоставил в УНИИМ (ГЦИ СИ) прибор - микроскоп измерительный ТМ-500, заводской № 260108, изготовленный фирмой "Mitutoyo Corporation" (Япония). Принцип действия микроскопа состоит в увеличении измеряемого объекта и передаче измеряемого размера объекта перемещению наконечника электронного микрометра, с помощью которого ... |
Раздел: Промышленность, производство Тип: дипломная работа |