Реферат: Характеристика засобів контролю поверхонь і поверхневого шару
ХАРАКТЕРИСТИКА ЗАСОБІВ контролю поверхонь і поверхневого шару
Вступ
Гарантоване одержання виробів з принципово новим рівнем функціональних та ін. властивостей, досягнення точності 0,1 мкм - 1 нм може бути отримано тільки за умови комплексної розробки високопрецизійних робочих процесів, вимірювальних систем, верстатів та ін. устаткування. Розміри деталей або їх елементів можуть складати широкий діапазон аж до декількох мкм, а точність верстатів повинна бути в межах 0,01 мкм.
1. Технологічне оснащення
Робочі процеси, пов'язані з механічною обробкою, базуються на надзвичайно високій точності характеристик переміщень верстата і геометрії інструмента. Субмікрометрична чи нанометрична точність переміщень верстата і геометрії інструмента є тут обов'язковими умовами. Металорізальні верстати, усе технологічне устаткування і вимірювальна апаратура включаються в єдину систему керування замкнутим циклом, що в сукупності забезпечує досягнення необхідної точності, швидкості та керування циклом позиціювання в системі інструмент-заготовка.
2. Засоби контролю поверхонь і поверхневого шару
фотоелектронна спектроскопія скануюча поверхня
У традиційних технологіях більшою мірою використовуються вимірювальні інструменти, прилади та пристрої, що дозволяють контролювати макро- і мікрогеометричні характеристики поверхні. Задача формування функціональних властивостей виробу породила необхідність розширення арсеналу засобів вимірювання та контролю, і призвела до використання фізичних методів досліджень: спектральний, рентгенівський і мікрорентгенівський аналізи, растрова та просвічуюча електронна мікроскопія, методи визначення залишкових мікро- і макронапруг, растрова та скануюча тунельна мікроскопія, атомна мікроскопія.
На початку 80-х німецький фізик Герд Бінніг та його швейцарський колега Генріх Рорер відкрили растрово-тунельний мікроскоп і одержали за нього в 1986 році Нобелівську премію в області фізики. За допомогою цього приладу можна спостерігати за поверхнею з точністю до атома. А зараз цей прилад є так само розповсюдженим, стандартним устаткуванням, як і його «молодший брат» - силовий мікроскоп. Досягнуто можливості вивчення нових поверхневих структур, атомних і молекулярних структур поверхні після різних способів формоутворення й обробки.
Таким чином, сьогодні в розпорядженні технологів, науковців може бути досить засобів для всебічної оцінки характеристик виробів на трьох рівнях:
• макроскопічному, коли глибина поверхневого шару, що перевіряється, складає 100-1000 мкм;
• мікроскопічному, коли глибина поверхневого шару, що перевіряється, складає діапазон від кількох сотень нанометрів до декількох мікронів;
• манометричний, коли цей шар не перевищує декількох атомних шарів.
Для оцінки топографії поверхні, її структури і шорсткості застосовують оптичну мікроскопію (ОМ), електронну мікроскопію (ЕМ), атомно-силову мікроскопію (АСМ), тунельну електронну мікроскопію (ТЕМ).
Кристалографію поверхневих шарів деталей після виготовлення оцінюють за допомогою гамма-променевої й енергетичної фотонної спектроскопії. Традиційна широко застосовувана гамма спектроскопія дає уявлення про структуру кристалографічних тіл та їх напружений стан. Для оцінки точності розміру й орієнтації окремого поверхневого кристаліту ефективними є методи електронної зворотно-розсіюючої дифракції.
Хімічну природу елементів у поверхні одержують мікрозондуванням, що дозволяє досліджувати об'єм до одного кубічного мікрометра. Різні методи спектроскопії, засновані на бомбардуванні фотонами чи електронами, ідентифікують природу поглинаючих шарів біля поверхні.
Ступінь геометричних, фізико-хімічних та кристалографічних змін у поверхневому шарі в процесі виготовлення виробу оцінюється цілим комплексом методів:
• електронна потенційна ОЖЕ-спектроскопія;
• електронна ОЖЕ-спектроскопія;
• концентричний-гемосферичний аналізатор;
• циліндричний дзеркальний аналізатор;
• високороздільна електронна енергетична спектроскопія;
• іонізаційна спектроскопія;
• інфрачервона рефлекто-поглинальна спектроскопія;
• високоенергетичне іонне розсіювання;
• рефлекто-високоенергетична електронна дифракція;
• гамма-променева фотоелектронна спектроскопія;
• ультрафіолетова фотоелектронна спектроскопія;
• скануюча електронна мікроскопія;
• метод поверхневої розширеної гамма-променевої точної структури;
• високороздільна електронна мікроскопія тощо.
Нижче наводиться коротка характеристика деяких з них.
2.1 Метод гамма-променевої фотоелектронної спектроскопії
Цей метод відноситься до неруйнівних методів контролю, тому що гамма-промінь, який використовується для одержання фотоелектронного спектра, відносно безпечний для багатьох матеріалів.
Джерелом гамма-випромінювання є нитка накалювання та цільовий анод. Напруга прикладається між ниткою й анодом для прискорення електронів, що випускаються з нитки в щілину анода. Електронне бомбардування щілини є причиною виникнення гамма-випромінювання. Для вироблення фотоелектричного спектра гамма-джерело здійснює монохромне випромінювання з достатньою енергією, щоб одержати ядра електронів всіх елементів періодичної таблиці. На рис. 1 представлена схема одержання фокусованого променя на установці Стенфордської синхротронної радіаційної лабораторії. Гамма-фотони з найближчого моноенергетичного променя направляються всередину зразка. Фотони поглинаються атомами, це супроводжується випромінюванням електронів. Електрони з орбіт всіх атомів з енергією зв'язку, меншою, ніж енергія гамма-променів, збуджуються неоднаково. Деякі піки в спектрі більш інтенсивні, ніж інші. Тому що атомні структури кожного елемента періодичної таблиці відрізняються від всіх інших, визначення позиції одного чи багатьох шляхів електронів дозволяє визначити присутність різних елементів у поверхні зразка.

Рис. 1
Метод поверхневої розширеної гамма-променевої точної структури (ПРГПС) дозволяє визначити зміни довжин молекулярних зв'язків з точністю до 0,05 А°, орієнтації молекул, що поглинаються поверхнею одиничних кристалів, визначити хімічний склад елементів і їх відносну концентрацію. Використовується для оцінки органічних поверхонь (полімери, змащення, покриття) та неорганічних (корозія, електрохімія, руйнування, електронне пасивування тощо).
2.2 Метод електронної ОЖЕ-спектроскопії
Метод електронної ОЖЕ-спектроскопії - один з найбільш застосовуваних аналітичних методів визначення хімічного складу поверхні твердих тіл. Його перевагою є висока чутливість в області 5-20 А° поверхні, швидке одержання даних і можливість оцінити всі елементи. Ефективне застосування при вивченні аномальних структур, дифузії, корозії й окислювання, адгезії, тертя і зносу, границь зерен, стабільності структур зерен, крихкості матеріалів порошкової металургії, крихкості матеріалів на залізній та незалізній основах тощо.
2.3 Метод Раман-спектроскопії
Для оцінки структурних характеристик поверхні широко застосовується метод Раман- і мікро-Раман-спектроскопії. Відноситься до неруйнівних методів контролю, не вимагає спеціальної підготовки зразків, можливе застосування для діагностики. Принципова схема представлена на рис. 2.
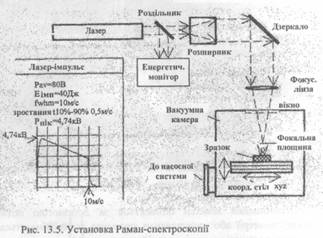
Рис. 2
Лазерний промінь направляється до зразка через оптичну систему. Промінь розширюється до діаметра плями контакту 13 мм і потім лінзами фокусується на поверхні зразка до плями розміром 0,5 мм. Зразок розміщається у вакуумній камері при тиску нижче 102 Па. Ефект Рамана – це розсіювання світла під тиском простих гармонійних коливань. Частота розсіяного матрицею світла може мати малу величину, що залежить від коливальних властивостей матриці. Раман-спектр поверхні твердого тіла виходить у результаті твердого розсіювання оптичних фотонів і введення в ґратки динамічних зондів. Частота фотонів точно відповідає типу структури і має відповідні до неї гострі та вузькі піки в спектрі. Повна ширина половини максимуму піка є показником досконалості кристала, а ступінь його розширення залежить від величини дефекту ґратки. Наприклад, різні алотропічні форми вуглецю (алмаз, графіт, аморфний вуглець) демонструють різні стани фонової щільності. Такі розходження можна використовувати для визначення різних алотропій на поверхні алмазного зношуваного інструмента, полікристалів алмазу після синтезу, при одержанні алмазних покриттів.
Мікро-Раман-спектроскопія дозволяє за рахунок вибору необхідного збільшення мікроскопа вивчати малі об'єкти і ділянки поверхні до 1 мкм2 (одиничні кристалічні плівки, малі концентрації домішок, нормальні напруги).
2.4 Атомна силова мікроскопія (АСМ)
Метод базується на зміні сил взаємодії часток, порівняних з атомом. Ці сили, впливаючи на наконечник, що переміщується уздовж поверхні, змушують згинатись консоль, на якій закріплений наконечник (рис. 3).
Переміщення консолі оцінюється за допомогою оптичної інтерферометрії або уловлювання променю, що відбивається від верхньої поверхні консолі, позиційно-чуттєвим фотодатчиком. При цьому фіксуються відхилення менш, ніж 0,01 А°. Ця ж задача вирішується за допомогою п'єзодатчика, вмонтованого в консоль. Енергія взаємодії двох атомів чи малих молекул описується відомим потенціалом Леннарда-Джонса, а сила взаємодії розглядається як функція відстані між ними (рис. 3). Ліворуч від мінімуму потенціалу частки відштовхуються одна від одної, а праворуч - - притягаються. Сила притягання (Ван-дер-Ваальса) змінюється як відстань між наконечником і зразком. Тому контакт наконечника і зразка повинен бути виключений, і поверхня сканується на відстані 50-200 А°, або контакт можливий при дуже малих зусиллях притискання наконечника до зразка.
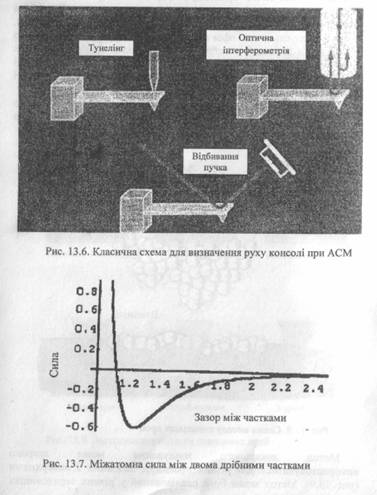
Рис. 3
2.5 Метод скануючої тунельної мікроскопії (СІМ)
Метод скануючої тунельної мікроскопії призначений для зображення поверхні з атомним вимірюванням. Скануюча тунельна мікроскопія є насправді поверхово чутливим методом, оскільки базується на ефекті тунельного струму, що є мірою взаємодії (додавання) електрохвильових полів електропровідних зонда та зразка в самому проміжку, що їх розділяє. Одержувані зображення залежать і від напруги (різниці прикладених потенціалів) між зондом та зразком.
Скануючи поверхню, зонд змушений робити переміщення по осі z для збереження величини тунельного струму постійною (рис. 4).
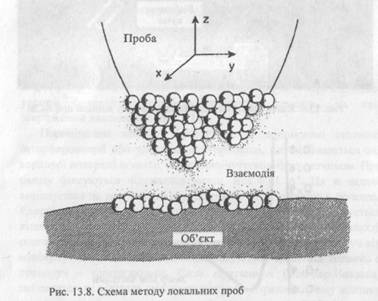
Рис. 4

Рис. 5
Метод локального зондування може широко використовуватися для різних процедур, зв'язаних з поверхнями (рис. 5). Метод може бути реалізований у різних середовищах (від ультрависокого вакууму до електроліту); можливе застосування для спектроскопії провідностей, розділової спектроскопії тощо.
| Рентгеноструктурний аналіз молибдену | |
|
Фізичні властивості молібдену Молібден (лат. Molybdaenum), Mo, хімічний елемент VI групи періодичної системи Менделєєва; атомний номер 42, атомна маса ... Фотон при зіткненні з електроном віддає йому частину енергії і імпульсу, і передає кінетичну енергію mѭ2/2 (мал. Згідно цій формулі, електронна хвиля порядка 1 A, відповідна довжині хвилі звичайно застосованого рентгенівського випромінювання, відповідає електронам з прискорюючою напругою 100 ... |
Раздел: Рефераты по физике Тип: дипломная работа |
| Фізичні основи роботи комп"ютера | |
|
Міністерство освіти і науки України Донецький національний університет Фізичний факультет Кафедра загальної фізики і дидактики фізики До захисту ... Під впливом світла (у лазерних принтерах джерелом високочастотного когерентного випромінювання є лазер) освітлені ділянки шару напівпровідника на фотобарабані зменшують ... Ця гіпотеза добре пояснює результати дослідів Ленарда: якщо кожен фотон в результаті зіткнення вибиває один електрон, то інтенсивнішому світлу даної частоти відповідає більше число ... |
Раздел: Рефераты по педагогике Тип: дипломная работа |
| Вплив процесів деформування на поверхневий шар металів | |
|
... університет "Львівська політехніка" Кафедра "Технології машинобудування" Курсова робота: " Вплив процесів деформування на поверхневий шар металів ... ... число електронів, що приймають участь у зв'язку атома з найближчими і наступними сусідами; ra - атомний радіус даного елемента; R1, R2 - відстані до найближчих і наступних сусідів. ... у процесі втоми, яка включає рух деформаційних дислокацій по площинах ковзання, вихід дислокацій на поверхню і появу атомних заряджених сходинок, що і є причиною зниження РВЕ. |
Раздел: Рефераты по физике Тип: курсовая работа |
| Електроніка та мікропроцесорна техніка | |
|
Інструкційна картка №1 для самостійного опрацювання навчального матеріалу з дисципліни "Основи електроніки та мікропроцесорної техніки" І. Тема: 1 ... Якщо електрони, рухомі з великою швидкістю, ударяються об поверхню металу, то їх кінетична енергія руху передається електронам металу. При позитивній напрузі на затворі відносно витоку поверхневий шар на межі НП з діелектриком збагачується електронами, які притягуються з глибини p-шару (де вони є завдяки тепловій ... |
Раздел: Рефераты по коммуникации и связи Тип: учебное пособие |
| Квантово-механічна теорія будови речовини | |
|
... Квантово-механічна теорія виникла на початку ХХ ст., коли було встановлено, що атом подільний, і за елементарні частинки було прийнято електрон і ... Послідовність заповнення атомних електронних орбіталей залежно від головного і орбітального квантових чисел дослідов В. М. Клечковський, який встановив, що енергія електрона ... Електронний захват полягає в тому, що електрон з найближчого до ядра шару захвачується ядром і при цьому один з протонів ядра перетворюється в нейтрон: р + = n. Наприклад: |
Раздел: Рефераты по физике Тип: учебное пособие |